1、硅穿孔(TSV)封装技术
■ 实现芯片间互连和在三维方向的高密度堆叠
■ 提高产品的信号传输速度
■ 降低内部功耗
■ 实现产品的性能最高而外形最小
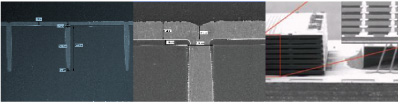
2、SiP射频封装技术
■ 射频技术可以广泛应用于无线通讯、身份识别等领域,市场前景十分广阔。

3、圆片级三维再布线封装工艺技术
■ 通过再布线设计,将原不规则排布的I/O电极进行阵列式排布。

4、铜凸点互连技术
■ 适用于高密度、大功率封装

5、高密度FC-BGA封测技术
■ 大幅度降低成本,缩小产品体积
6、多圈阵列四边无引脚封测技术
■ 替代500脚以下传统封装的一种新的封装技术
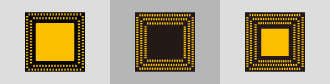
7、封装体三维立体堆叠技术
■ 充分节省产品占用PCB的面积、减少信号干扰。

8、50μm以下超薄芯片三维立体堆叠封装技术
■ 超大圆片超薄磨片技术
■ 超大圆片超薄划片技术
■ 超薄芯片堆叠装片技术
■ 超薄多层芯片打线技术
■ 多层芯片超薄包封技术

9、MEMS多芯片封装技术
■ MEMS圆片贴装技术
■ MEMS圆片切割技术
■ MEMS产品贴片技术
■ MEMS芯片间打线技术
■ MEMS产品涂布技术
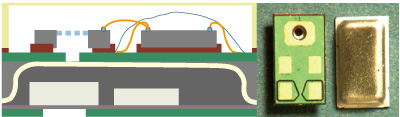
Copyright © 深圳市科力微电子有限公司 All Rights Reserved 粤ICP备16047389号
 简体中文
简体中文 English
English


